本装置はDCまたはRFイオンソースを使用し、基板回転冷却シングルステージを搭載したイオンビームエッチング/ミリング装置です。
新製品 イオンビームエッチング装置(IBE装置) Jシリーズ J440
コンパクト設計
イージーオペレーション及び拡張性

特長
- 微細加工が難しいAu,Pt,磁性材料の加工
- 基板表面温度100℃以下での処理が可能
- 有毒ガスを使用しないクリーンプロセス
- 省スペース化
架台内に全構成品収納。コンパクトなサイズで設置場所を選びません。 - 柔軟な加工性
容易にテーパー加工、斜め照射ミリング可能。 - 液晶タッチパネル&PLC制御
自動排気、プロセスの自動化等レシピ設定可能。
エラー表示及びデーターロギング。
用途
センサー、SAWデバイス、薄膜磁気ヘッド、MEMS、電子顕微鏡サンプル作成など
導入分野
研究開発、試作品開発、少量生産
標準仕様
| 対応基板 | 最大φ4インチ |
|---|---|
| 基板ステージ | 自転、入射角度(0~±90°)可変 |
| ステージ冷却 | ドライチャック、空冷式チラー |
| イオンソース | 米国KRI社製 カウフマンイオンソース KDC40 |
| ビーム仕様 | ビーム電圧100-1200V、電流最大100mA |
| グリッド | セルフアライメントTMMo製2枚4cmグリッド |
| 真空排気系 | 大気圧から10-4Pa台まで30分以内 (標準でターボ分子ポンプ、RP、広帯域真空ゲージ、ゲートバルブレス構造) |
| チャンバー | SUS製φ410XL280mm、ビューポート付き |
| 制御系 | 7インチタッチパネル&PLC制御 |
| 寸法、重量 | 780mm(W)X 950mm(L)X 1700mm(H)以内 約500kg |
オプション
- 各種グリッド(Mo、カーボン、発散、収束及びコリメート)
- エッチング均一性向上(KDC75)及び各種ニュートラライザー
- イオンビームデポジション(IBS)装置へのステップアップ
- ゲートバルブ追加、ドライポンプへの変更
- エンドポイント機能(光又はQマスタイプ)
※基板の複数枚処理(自転公転ステージ)及び簡易LL機構を搭載した、Kシリーズ及び Lシリーズもございます。
必要諸元
- 3相AC200V,15A
- Arガス(プロセス用)
- N₂ガス(チャンバーベント用)
- 圧縮空気(バルブ駆動用)
弊社では、お客様のご仕様に基づいて最適な装置構成をご提案致します。
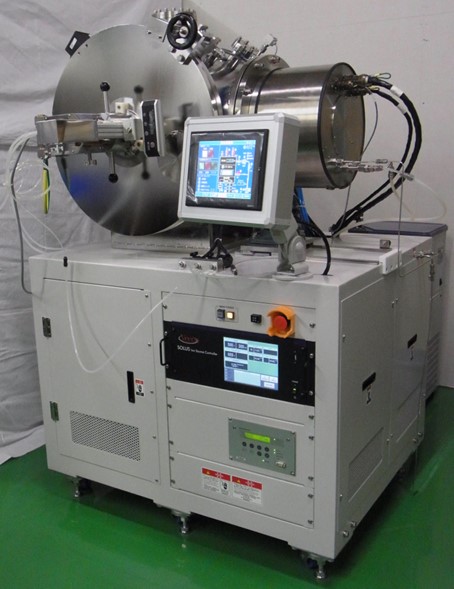
イオンビームエッチング装置/ミリング装置(IBE/IBM装置)の特徴
- 微細加工に適しています
- Au, Pt, 磁性材等を容易にエッチング
- テーパー加工が容易
- 基板表面温度80℃以下での処理が可能
- 有毒ガスを使用しないため、排ガス処理不要
- エンドポイントディテクター搭載可能
